在此場合下BGA、CSP中央部分將存在間隙G,為填充該間隙G所必需的釬料量(如圖6所示),其體積V可按下式求得。為填補這個間隙G所必需的釬料量,即最大釬料量Qmax,可按下式求得Qmax=πD^2G/4(mm3) (2)
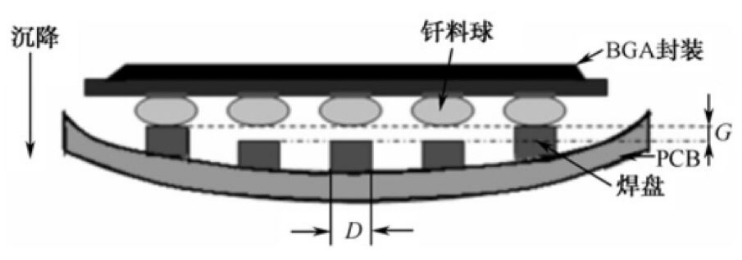
圖6 必需釬料量的確定
二、焊盤設計
圖7所示為BGA、CSP封裝結構參數,表1所示為供應商提供的相關具體標稱尺寸,在此基礎上進行PCB焊盤設計。
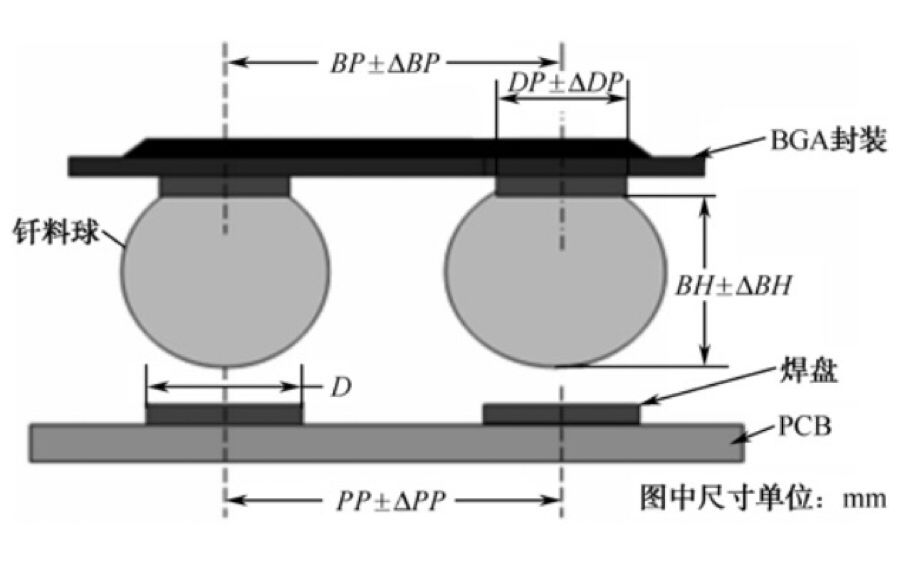
圖7 焊接接合部焊盤尺寸的確定
表1 BGA、CSP封裝釬料球尺寸
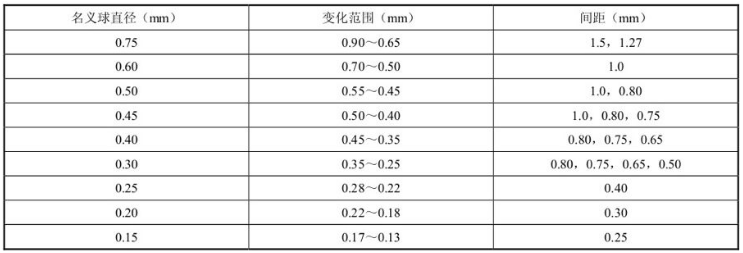
由于BGA、CSP的焊盤形狀大部分均采用圓形,故接合部焊盤設計的主要內容是:1)確定圓形焊盤的最大直徑(Dmax)前面已討論了從可靠性看焊盤接合部的最薄弱的部分,也就是斷面最小的地方。因此,PCB基板上的安裝焊盤最大直徑(Dmax)的取值通常就與BGA、CSP封裝焊盤直徑相同,即Dmax=BGA、CSP封裝的焊盤直徑 (3)2)確定圓形焊盤的最小直徑(Dmin)圓形焊盤的最小直徑(Dmin)通常可通過BGA、CSP的貼裝精度和BGA、CSP本身的尺寸精度,再綜合由熔融釬料的表面張力所形成的自調整作用的影響來求得,即

式中 δ5——貼片精度;ΔBP——釬料球間距精度;ΔPP——PCB焊盤間距加工精度。三、印刷鋼網開口尺寸的確定1.鋼網開口直徑設計就鋼網開口部設計與焊盤相比,當印刷機位置精度較高時,其設計方法基本上與片式元器件相同。此時,為不使釬料量過多,將位置精度估計為0.05mm,故鋼網開口直徑=焊盤直徑-0.05 (3)2)印刷厚度的管理值一般在焊膏的總體積中,釬料合金含量與助焊劑等的體積大約各占總體積的一半。
由此,可得出具體焊膏印刷體積控制范圍為Vmax=2Qmax (4)Vmin=2Qmin (5)由式(3)~式(5)可求得對應的最大印刷厚度Tmax和最小印刷厚度Tmin。Tmax=Vmax/(鋼網開口面積) (6)Tmin=Vmin/(鋼網開口面積) (7)3)工藝可靠性設計注意事項由于BGA、CSP組裝后的焊點檢測是困難的,因此,必須按照工藝設計的基本思路,把獲得完好的質量放在第一位,這時一個非常重要的因素是保證釬料的潤濕性。如前所述,BGA、CSP再流焊接時釬料的表面張力產生的沉降現象和自調整效果,有利于焊點質量的改善。